Unique expertise to industry standards
Sandia’s expertise in novel failure analysis has developed many techniques that are now industry standards. Our mission continues to develop expertise in Si CMOS, III-V, MEMS, and optoelectronics reliability, and both failure and functional analysis throughout the entire product lifecycle.
Techniques and Tools
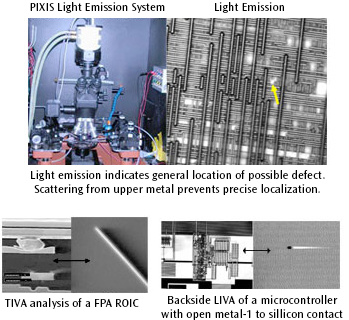
- Light Emission-based Techniques for localizing fabrication defects
- Laser Based Techniques: Thermally Induced Voltage Alterations (TIVA), Light Induced Voltage Alterations (LIVA)
- E-Beam Based Techniques: Passive Voltage Contrast (PVC), Charge-Induced Voltage Alteration (CIVA)
- Atomic Force Microscopy
- Laser Scanning Microscopy
- Scanning Electron Microscope (SEM) including nano-probing and environmental mode
- Focused Ion Beam (FIB) – Dual Beam and Backside circuit edit
- Transmission Electron Microscope (TEM), including aberration corrected STEM with enhanced atomic-scale compositional analysis capability and one of the Nation’s only In-situ Ion Irradition TEMs (I3TEM, in our Ion-Beam Laboratory facility)
- Low-Energy Electron Microscopy and Photo-Emission Electron Microscopy
- Superconducting Quantum Interference Device (SQUID)
- Extensive package and chip deprocessing and analysis capabilities
